在用於EUV光刻的光掩膜上實現2納米世代以後的精細圖案的解析度
面向新一代半導體的高NA EUV光掩膜評估用光掩膜也開始提供
2024年12月12日
Dai Nippon Printing Co., Ltd.(總部:東京;總裁兼董事:北島義孝;以下簡稱:DNP)已成功解決了 2 奈米(nm:10⁻⁹ m)及以上世代邏輯半導體光紫外光掩模所需的精細圖案*1,這些圖案與半導體製造中最先進的 EUV(極紫外光刻)技術相容。
此外,DNP完成了與高開口數 (高NA) *2兼容的光掩模的基礎評估,該光掩模計劃應用於2nm工藝及更高世代半導體,我們開始向半導體開發聯盟,制造設備制造商,材料制造商等提供評估光掩模。高NA-EUV光刻可以在硅晶圓上形成解析度比以前更高的精細圖案,從而有望實現高性能和低功耗的半導體。
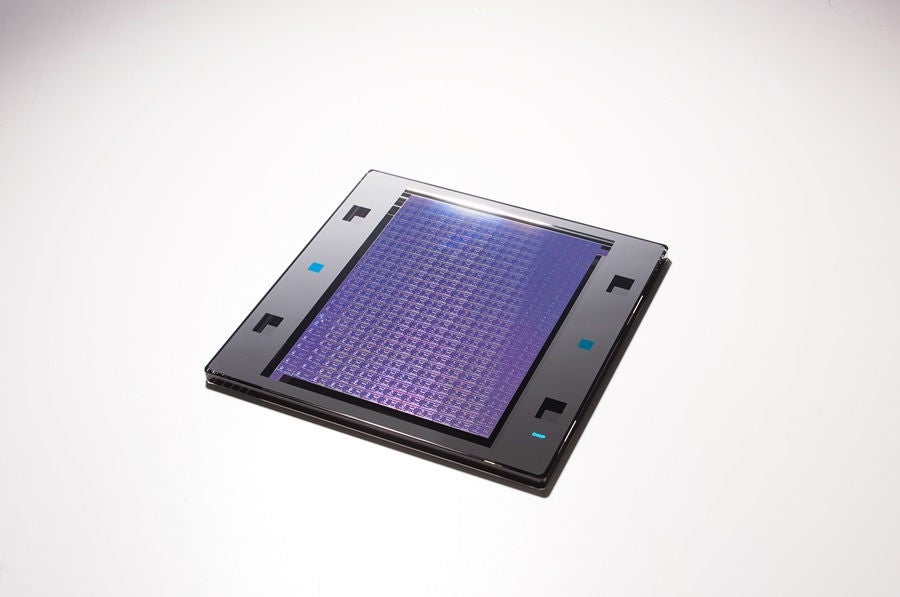 用於EUV光刻的光掩模超過2納米生成
用於EUV光刻的光掩模超過2納米生成
近年來,在最先進的邏輯半導體中,使用EUV光源的EUV光刻的大規模生產進一步發展,存儲半導體的採用也在擴大,EUV光刻對於提供最先進的半導體是不可或缺的。
2023年,DNP完成了3nm EUV光刻光掩模製造流程的開發*3。2024年,DNP作為分包商參與了新能源產業技術綜合開發機構(NEDO)的“後5G信息通信系統基礎設施強化研發項目”,Rapidus株式會社(總部:東京,總裁兼董事:小池敦義)也參與其中,DNP正在開發與尖端邏輯半導體光掩模邏輯的製造工藝和質量保證相關的技術*4。
【開發概要】
此次,DNP成功地將面向尖端領域半導體制造的2nm以後的邏輯半導體光掩膜所需的微細圖案解析為面向EUV光刻的光掩膜。除此之外,我們還完成了與高NA相對應的EUV光掩模的基本評估,該光掩模被認為適用於2nm之後的下一代半導體,並開始提供樣品掩模。
【開發要點】
- 2nm工藝以後的EUV光刻用光掩膜的實現要求圖案比3nm工藝縮小20%以上。需要一種技術來解析同一蒙版上的所有精細圖案,包括更復雜的曲線圖案,以及一般的直線和矩形圖案以及尺寸和形狀。通過在已建立的3nm制造工藝的基礎上不斷改進,DNP實現了2nm之後所需圖案的解析度。
 在用於極紫外光刻的光遮罩上,線寬為 17 nm 的線-空圖案影像
在用於極紫外光刻的光遮罩上,線寬為 17 nm 的線-空圖案影像
 EUV光刻光罩上的精細曲線圖案圖像
EUV光刻光罩上的精細曲線圖案圖像
- 用於高NA-EUV光刻的光掩膜比用於常規EUV光刻的光掩膜需要更高的精度和更精細的加工。DNP構建了與普通EUV光刻光掩膜不同的制造工藝流程,並在此基礎上進行了優化。
【今後的發展】
DNP今後將進一步確立提高制造成品率等生產技術,力爭2027年度開始供應面向2nm工藝邏輯半導體的量產光掩膜。此外,我們將繼續與總部設在比利時的最先進的國際研究機構imec合作,推動1nm工藝光掩膜制造技術的開發。DNP在國際半導體產業中,與各種合作夥伴合作推進開發,為日本半導體產業的發展做出贡獻。
*1符合國際設備係統路線圖(IRDS:International Roadmap for Devices and Systems)標準
*2 Numerical Aperture (NA) 表示光學係統的亮度和解析度。高NA是將EUV曝光設備的鏡頭開口數從傳統的0.33擴大到0.55。
*3 3ナノメートル相当のEUVリソグラフィ向けフォトマスク製造プロセスを開発(2023年12月12日)→ https://www.dnp.co.jp/news/detail/20170116_1587.html
*4 2ナノメートル世代のEUVリソグラフィ向けフォトマスク製造プロセス開発を加速(2024年3月27日) → https://www.dnp.co.jp/news/detail/20173719_1587.html
- 所列產品規格、服務內容等均為發佈日期。之後可能會發生變更,恕不另行通知,敬請諒解。
